评估电子元件老化和稳定性的高温老化方法
了解由于使用石英晶体的温度和时间,以及应用外推方法、老化方程和Arrhenius方程,电子元件的老化和稳定性挑战。
即使有固定的输入,电子电路也不是完全稳定的;经常随时间和温度漂移。这些与理想行为的偏差会给精确测量增加相当大的误差。随时间漂移,也称为长期稳定性,是需要长时间高精度应用的关键因素。测量系统的初始精度误差通常可以通过初始校准来消除;然而,消除长期漂移的误差需要定期校准。此外,这些校准在某些工业、医疗、军事和航空航天应用中可能不切实际。
在这篇文章中,我们将介绍评估电子元件长期稳定性的高温加速老化方法的基础知识。虽然我们将以典型石英晶体的老化行为为例,但类似的概念有时也适用于其他组件。
石英晶体老化机理——传质效应
晶体的共振频率随时间而变化。石英晶体的两种主要老化机制是传质和应力释放。当向晶体中添加或从晶体中去除少量质量时,谐振频率会发生变化。为了尽量减少传质效应引起的晶体老化,晶体的制造过程应尽可能清洁。
下图1中,橙色曲线显示了由于污染引起的传质而随时间漂移的晶体的典型老化行为。
一个显示传质引起的时间漂移的例子。
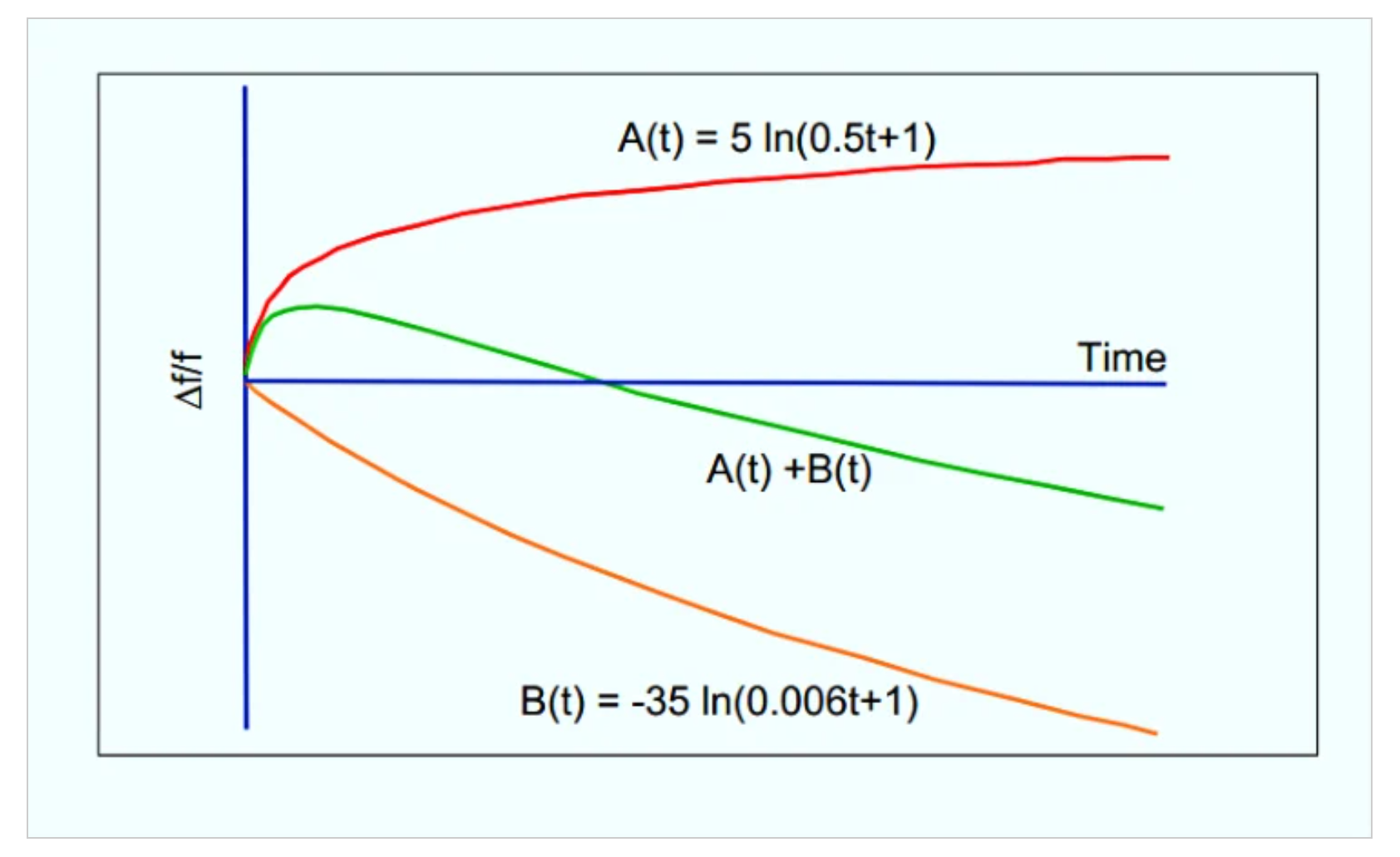
图1。一个展示不同衰老因素和行为的例子。图片由J.Vig提供
谐振频率还取决于施加到晶体上的应力。这种应力可能是由PCB或封装材料引起的。随着时间的推移,这些应力会降低并导致晶体谐振频率的变化。
图1中的红色曲线显示了由应力释放效应引起的典型老化行为。如果晶体的老化主要由传质效应主导,其老化曲线将接近B(t)。对于受应力释放效应影响的晶体,其老化行为将接近a(t)。总体老化行为(图1中的绿色曲线)将是这两条曲线的总和。
通过外推法进行老化预测
基于上述讨论,我们可以使用以下对数函数来描述谐振频率随时间的变化:

方程式1。
在这个方程中,a、b和c是常数,应该通过将模型与特定类型晶体的测量数据相关联来获得。这些常数可以通过应用最小二乘拟合过程来找到。图2显示了在室温下从晶体收集的频率漂移数据,以及通过将上述对数模型拟合到测量数据而获得的曲线。
来自室温晶体的频率漂移数据集和使用对数模型的曲线。

图2:来自室温晶体的频率漂移数据集和使用对数模型的曲线。图片由S.J.Griffin提供
有了模型参数,我们可以估计测试持续时间之外的频率漂移。在示例文献中,这种方法有时被称为外推法。这种方法的缺点是它需要很长的测试时间。在上述示例中,捕获约250天的频率漂移数据以找到模型参数。在一篇名为“石英晶体单元的老化预测”的示例论文中,在室温下测量了6个月(4320小时)的晶体谐振频率,以便能够准确确定一年后的频率漂移。由于此类测试的成本过高,研究人员试图找到更有效的衰老预测技术。为了更好地理解这些方法,我们需要更仔细地研究晶体的老化特性,我们稍后将对此进行介绍。
此外,值得一提的是,上述对数函数是一个相对简单的模型,还有其他更复杂的模型可以更好地描述晶体的老化行为。
一个通用的石英晶体老化方程
由方程1给出的对数模型仅指定了老化过程的时间依赖性。石英晶体的一般老化方程可以写成:

方程式2。
其中R1(i)、R2(T)和R3(T)分别考虑了对驱动水平、温度和时间的依赖性。驱动电平是指晶体中消耗的功率量。超过规定的驱动器级别会缩短设备的寿命。在检查老化效应时,选择适当的驱动器级别以最小化由驱动器级别依赖性引起的频率变化。忽略驱动器级别效应,方程式2可以写成:

通过上述对数方程对老化过程的时间依赖性进行建模,我们得到:

方程式3。
正如你从这个方程中看到的,为了对衰老过程有一个更准确的模型,我们需要确定衰老机制的温度依赖性。这可以通过下面讨论的Arrhenius定律来实现。
基于Arrhenius方程的温度依赖模型
在物理化学中,Arrhenius方程是一个描述反应速率温度依赖性的公式。根据Arrhenius方程,化学反应的速率常数对绝对温度的依赖关系由下式给出:

方程式4。
在上述方程式中:
Ea是反应的活化能(单位与KBT相同)
kB=8.617✕10-5eV/K是玻尔兹曼常数
T是开尔文温度
A是一个常数
根据该方程式,通过提高温度(T)可以加速反应。当应用于老化预测问题时,Ea是老化过程的活化能。应该指出的是,并非所有的衰老机制都遵循Arrhenius定律。
假设感兴趣晶体的老化遵循Arrhenius方程,方程3可以表示为:

在某些假设下,上述方程可以简化为:

方程式5。
其中d是常数。
高温加速老化
方程式5解释了老化过程如何随时间和温度变化。由于老化过程在高温下加速,我们可以将晶体在高温Ttest下浸泡相对较短的时间,以预测在正常工作温度Tuse下更长时间的老化效果。
从方程式5中,我们得到:

例如,Ea=0.2eV,Ttest=85°C,Ttest=7天,Tuse=25°C,Tuse=365天;上述比率等于约2。这意味着,在Ttest=85°C的温度下,晶体在Ttest=7天内的老化时间大约是Tuse=25°C的晶体在Tuse=365天内老化时间的两倍。因此,为了估计在25°C下一年后的晶体老化,我们可以测量在85°C下浸泡7天的晶体的老化。将该值除以2,我们可以得到一年后在25°C下的晶体老化。
要应用上述方法,我们需要知道老化过程的活化能。这将在本系列的下一篇文章中讨论。应该指出的是,Arrhenius方程有一些局限性。事实上,你可以在研究论文和制造商的技术文件中找到关于这种方法的相互矛盾的意见。在下一篇文章中,我们也将探讨其中一些相互矛盾的观点。

加入微信
获取电子行业最新资讯
搜索微信公众号:EEPW
或用微信扫描左侧二维码