大芯片集成将迎来多年高速增长期
关于 Chiplets(俗称小芯片,也就是将不同制程工艺的裸片 die 封装在一起,组成一个系统级大芯片)的发展前景,最近,有机构给出了一份非常乐观的预测报告。
据 http://Market.us 统计和预测,2023 年,Chiplets 市场规模为 31 亿美元,2024 年将达到 44 亿美元,到 2033 年,将增长到 1070 亿美元,2024~2033 年的复合年增长率(CAGR)将达到 42.5%。

2023 年,高性能 CPU 占据 Chiplets 市场的主导地位,份额达到 41%。在高性能计算(HPC)应用领域,模块化的 CPU 设计提供了更高效的处理能力,CPU Chiplets 与其它类型 Chiplets(如 GPU 和内存)集成的灵活性也推动着它们的普及。
GPU Chiplets 也越来越受欢迎,尤其是在高端游戏、人工智能和机器学习应用中;内存 Chiplets 也至关重要,特别是在需要大型快速内存池的应用中,例如大数据分析和云计算。
2023 年,由于智能手机、笔记本电脑和可穿戴设备的进步,消费类电子产品以超过 26% 的份额主导着 Chiplets 应用市场;IT 和电信服务应用占比在 24% 左右,这主要得益于数据中心的高性能计算需求增长。
2023 年,亚太地区成为 Chiplets 的主导力量,占据了 31% 的市场份额,这主要得益于该地区先进的半导体制造能力和快速的技术进步。
为何如此看好 Chiplets 市场?
用 10 年时间,从 31 亿美元增长到 1070 亿美元的市场规模,这样的增长速度是很快的。那么,业界和机构为何如此看好 Chiplets 的发展前景呢?原因是多方面的。
首先,从芯片设计和制造两方面看一下 Chiplets 能够提供的益处。
Chiplets 的迷人之处在于它的用途是多样化的,关于这方面的情况,AMD 和英特尔经常谈及,采用 Chiplets 设计,可以更容易地为 HPC 应用市场和客户提供定制化解决方案。增加或减少处理器核心数量,或者将一个 die 换成另一个更合适的 die 非常简单。例如,AMD 的服务器 CPU 不仅比台式机型号拥有更多的 CPU Chiplets,还具有更大更好的 I/O 接口。AMD 还通过其 3D V-Cache 方案为处理器添加功能组件,从而为买家提供更多选择。英特尔则表示,可以跨代重复使用 Chiplets,这是英特尔非常看重的优势。
处理器在制造过程中会有缺陷,而且,芯片越大,就越容易出现缺陷,从而降低产量。而较小的芯片则不容易出现缺陷,因此,采用 Chiplets 方案,可以将传统 SoC 大芯片分化成多个小的 die,然后用先进封装组合在一起,这样,可以在很大程度上节省制造成本。在具有高缺陷率的先进制程工艺节点(5nm,3nm 等)上,这种效果更为明显。
要实现 1070 亿美元的市场规模,只有以上提到的设计和制造优势是不够的,Chiplets 还必须在未来这些年充分发挥其多方面的优势,包括:要允许在单个芯片上集成更多种类的微架构 die,其复杂程度会越来越高;充分发挥供应链灵活性,Chiplets 的模块化特性为供应链提供了更大的灵活性,应用厂商可以从不同的供应商采购不同的组件,从而减少对单一来源的依赖。
要想将 Chiplets 推向更高水平,需要产业链涉及的企业通力合作,该市场包括 Chiplets 提供商,系统集成商,以及参与设计和制造的公司。
AMD 是将 Chiplets 成功商业化的先驱。该公司在 2017 年采用多芯片模块设计,推出了以 Zen 架构为主的 Chiplets 处理器,其中,高端型号使用多个 CPU die 来增加内核数量,而不是通过单个更大的芯片实现。在 2019 年的 Zen 2 架构产品中,AMD 将其 CPU 一分为二,一个是 CPU 内核 Chiplets,另一个是 PCIe 接口和 RAM 连接器 Chiplets。之后这些年,该公司不断更新相关技术和产品,使得产品性能和市场影响力越辣越强。
AMD 取得成功后,英特尔一直在努力开拓自家的 Chiplets 技术和市场空间,该公司称之为 tiles,名字虽然不同,但意思是一样的,也是 Chiplets。
除了 AMD 和英特尔,富士通(Fujitsu)和博通(Broadcom)等公司也在开拓 Chiplets 应用市场,进行相关处理器的研发和制造工作。另外,苹果(M1-Ultra CPU),以及中国的寒武纪(思远 370 系列 ASIC),壁仞科技(BR100 系列 GPU)也推出了自家的 Chiplets 产品。不过,AMD 和英特尔是迄今为止唯二两家批量生产 Chiplets 处理器的公司。
Chiplets 必须有先进封装技术的支持才行,目前,行业主要采用以下几种封装技术来实现:MCM(Multi-Chip Module),CoWoS(Chip-on-Wafer-on-Substrate),EMIB(Embedded Multi-die Interconnect Bridge)。
MCM 是指通过 Substrate (封装基板) 走线将多个芯片互联的技术;CoWoS 是由台积电主导的、基于 interposer (中间介质层) 实现的 2.5D 封装技术,其中,interposer 采用成熟制程工艺,可以提供比 MCM 更高密度和更大速率的接口。目前,主流的 CoWoS 技术包括 CoWoS-S、CoWoS-R 和 CoWoS-L;EMIB 是由英特尔主导的 2.5D 封装技术,使用多个嵌入式桥接芯片 (Silicon Bridge) 实现芯粒间的高速互联。
Chiplets 并不是万能的
虽然 Chiplets 很火热,但要实现全行业的大规模量产还需要时间。此外,die 的良率、封装良率、各种成本等,是采用该种方案的关键考量因素。只有在良率和成本等方面明显优于传统 SoC 方案时,才有采用 Chiplets 方案的必要,反之,还是老老实实地采用传统芯片设计和制造方案为好。
是否用 Chiplets 方案,关键考量因素是成本。下面,我们用清华大学马恺声老师所著的《算一算 Chiplet 的成本!》一文所举的例子加以说明。
下面这这幅图中的 9 个柱状图,都是 RE Cost(recurring engineering cost,不考虑一次性投入,生产一个芯片的成本),横向分别是 14nm,7nm,5nm 制程,纵向是封装到一起的 Chiplets 数量。
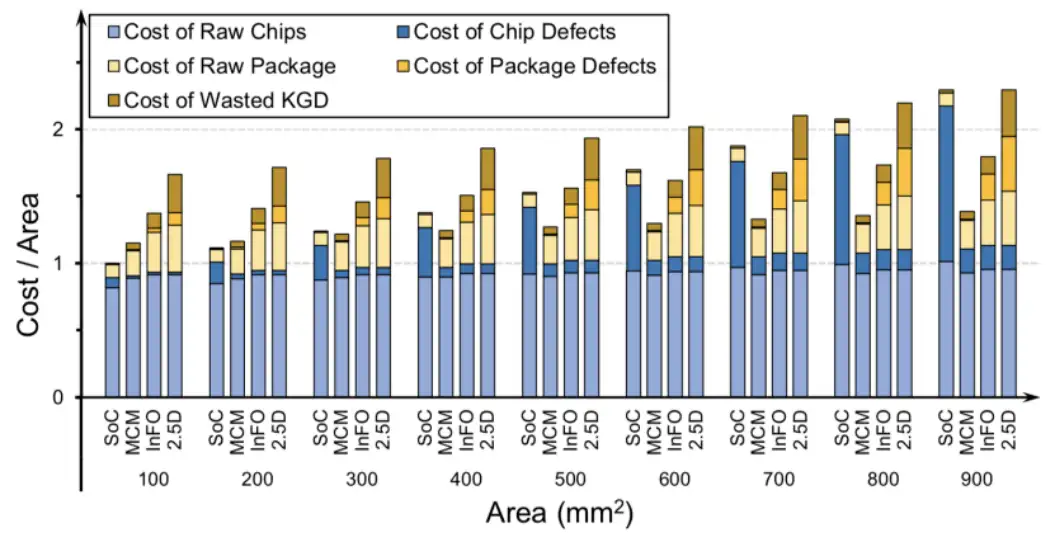
如果整个芯片面积在 200 平方毫米以下,则没有必要用 Chiplets,真正有价值的是在 800 平方毫米以上的大芯片,因为成本上是划算的。此外,先进封装需要大量测试,而且,最先进的封装都非常昂贵,甚至数倍于晶圆加工成本。未来,随着封装技术不断成熟和成本的下降,Chiplets 有望拓展出更多应用空间。目前,MCM 和 InFO 封装成本相对较低,更划算。
在 800 平方毫米的大芯片中,晶圆缺陷导致的额外成本占总制造成本的 50% 以上,对于相对成熟的制程工艺(14nm),尽管产量的提高也节省了 35% 左右的成本,但考虑到封装开销(MCM>25%,2.5D>50%) 及其它成本,Chiplets 的成本优势被减弱了。因此,制程工艺越先进(如 5nm、3nm),且采用的先进制程 die 越多,就越适合采用 Chiplets 方案,此时的成本优势非常明显。
一次性投入的成本也很重要,特别是对于没有大规模量产的产品。做先进制程工艺的 die,需要投入的一次性成本是很高的,如流片时掩膜板的成本,因此,Chiplets 方案需要的一次性总投入很高(50 万产量时占到总成本的 36%)。对于 5nm 制程系统,当产量达到 2000 万时,采用 Chiplets 方案才划算。有一点需要注意,那就是一次性投入成本可以随着 Chiplets 的复用,获得很大收益。
综合考虑成本、性能等多方面因素,Chiplets 最大的应用场景是需要采用异质集成的应用,例如将 CPU、GPU 与 DRAM 集成,以克服存储墙;其次是体积严重受限的应用,例如在手机中,通过 Chiplets 将多个 die 集成在一起,以减小体积;再有,就是使用环境恶劣的场景,例如汽车、工业控制、物联网等。
存在的挑战
要想发展到 1070 亿美元的市场规模,并不会一帆风顺,这一过程中,Chiplets 会遇到诸多挑战。其中,标准化和互操作性是最大挑战,Chiplets 市场的增长在一定程度上受到不同制造商组件之间标准化和互操作性需求的影响,因此,建立全行业标准对于 Chiplets 的广泛采用至关重要。
目前,各大芯片厂商在 Chiplets 接口的互联协议上各自为战,每家公司选择不同的技术线路和标准,往往是基于公司过往的技术积累,并不能通用,碎片化、定制化的接口标准对于 Chiplets 行业发展极为不利。为了解决这一难题,2022 年 3 月,英特尔、AMD、台积电、微软、Arm 等十大行业巨头宣布成立 UCIe 联盟。
今后,很可能会出现一种新的商业模式,即通过集成标准 Chiplets 来构建专用芯片,这也是一些国际大厂打造 Chiplets 标准的原因。通过标准的设立,可以把自家生产的芯片变成 Chiplets 企业使用的标准产品,集成到各种应用设备中。
除了标准和互操作性,Chiplets 还面临着芯片设计和验证工具更新,以及先进封装技术升级的挑战。
从设计的角度来看,Chiplets 系统在复杂度提升的同时,成品率反而在下降,而且,Chiplets 的性能最终取决于性能最高的那个。这对设计和验证提出了新的要求,由于 Chiplets 间的堆叠和互联,设计时不仅要考虑不同的制程工艺、不同架构的集成,还要加入高速互联总线和各类接口,相比于传统大芯片设计,Chiplets 方案对 EDA 软件的要求明显不同,目前,全球三大 EDA 软件厂商已经在布局对应的平台,相关的技术融合和行业并购正在或即将进行。
传统封装一般通过线路焊接的方式进行,为保证 Chiplets 之间更快的互联速度,会采用 2.5D/3D 等无需线路焊接的先进封装方式;从 2D、2.5D 到 3D,可以理解为平面上建高楼,楼建的越高,住的人也越多,能装下的晶体管也更多。封装技术的发展也要跟上市场需求,否则,Chiplets 的价值会大打折扣。
中国要大力发展 Chiplets 吗?
中国也在积极发展 Chiplets,为此,中国 Chiplets 联盟推出了相应的互连接口标准 ACC 1.0(Advanced Cost-driven Chiplet Interface 1.0),它由一批专门从事芯片设计,IP,以及封装、测试和组装服务的公司开发。该组织强调,中国产业链上的供应商需要合作,以建立一个完整的 Chiplets 生态系统。
对于发展 Chiplets,中国也需要理性对待,不能一哄而上,因为它的应用是有前提的,如前文所述,Chiplets 并不是万能的,它更适合以先进制程(5nm 及以下)为主导的芯片产品,就目前而言,中国大陆在这方面还比较弱。
对于发展本土 Chiplets 技术和产品,清华大学教授魏少军认为,要从应用的角度去考虑如何采用第三方 Chiplets 来实现集成,重点是 Chiplets 的集成而不是设计,采用业界成熟的标准成为必然。是否要制定中国自己的标准,取决于产业发展的需求,更取决于自身产业发展的水平,魏少军直言,超出产业发展的实际情况制定标准,通常会落入「为了标准而标准」的陷阱。
魏少军表示,中国集成电路产业总体上还处在追赶阶段,Chiplets 的出现并不能带来这一态势的根本改变。我们用到的 Chiplets 和相应的 EDA 工具依然要依赖国外厂商,更为悲观的看法是 Chiplets 的出现会使中国企业在价值链上的位置进一步下移,这样,过去 20 年在芯片设计上的积累会被削弱。不过,魏少军也指出,中国企业也可以在 Chiplets 领域有所作为,例如,可以借助 Chiplets 更快地发展应用,能促使中国企业向标准 Chiplets 方向转型。
关键词: Chiplets

加入微信
获取电子行业最新资讯
搜索微信公众号:EEPW
或用微信扫描左侧二维码