三星率先开发出12层3D硅穿孔堆叠:HBM存储芯片容量提至24GB
作者:万南
时间:2019-10-08来源:快科技
三星电子宣1布率先在业内开发出12层3D-TSV(硅穿孔)技术。
随着集成电路规模的扩大,如何在尽可能小的面积内塞入更多晶体管成为挑战,其中多芯片堆叠封装被认为是希望之星。三星称,他们得以将12片DRAM芯片通过60000个TSV孔连接,每一层的厚度仅有头发丝的1/20。
总的封装厚度为720μm,与当前8层堆叠的HBM2存储芯片相同,体现了极大的技术进步。
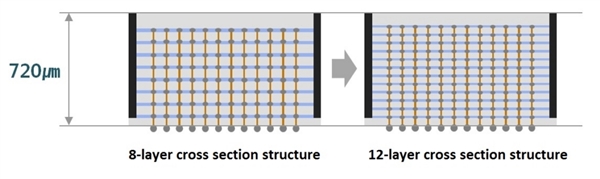
这意味着,客户不需要改动内部设计就可以获得更大容量的芯片。同时,3D堆叠也有助于缩短数据传输的时间。
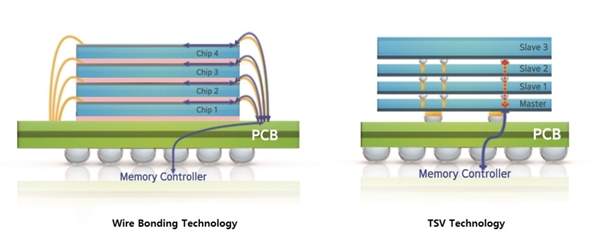
三星透露,基于12层3D TSV技术的HBM存储芯片将很快量产,单片容量从目前的8GB来到24GB。
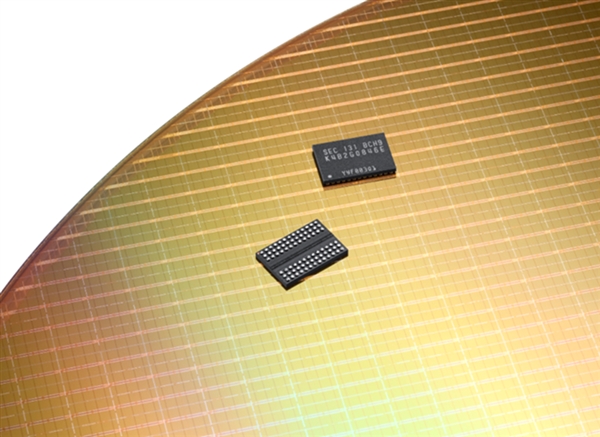

加入微信
获取电子行业最新资讯
搜索微信公众号:EEPW
或用微信扫描左侧二维码
相关文章
-
国际视野 2024-06-04
-
-
2024-05-30
-
-
-
-
-