3D封装技术英特尔有何独到之处
编者按:在半导体领域,3D技术带来的革命更叹为观止,早些年的FinFET和3D NAND只是个开始。从去年12月初英特尔公布新架构路线,到1月初CES 2019上拿出M.2 SSD大小的整台电脑,这样的速度,你不得不更上!
立体种植晶体管,对不起,暂时还不能。3D封装说得很清楚,就是在空间中而不是平面化封装多个芯片。也许你会说,这有什么新鲜的,芯片堆叠技术不是老早之前就被广泛使用了么,无论是DRAM还是NAND,都已广泛采用堆叠技术,特别是NAND已经从128层甚至更多层迈进。而智能手机所使用的SiP芯片,也是将SoC与DRAM堆叠在一起的。
DRAM/NAND堆叠相对简单,由于各层半导体功能特性相同,无论是地址还是数据,信号可以纵穿功能完全相同的不同楼层,就像是巨大的公寓楼中从底到顶穿梭的电梯。存储具有Cell级的高度相似性,同时运行频率相对不高,较常采用这种结构。

SoC和DRAM芯片的堆叠,采用了内插器或嵌入式桥接器,芯片不仅功能有别,而且连接速度高,这样的组合甚至可以完成整个系统功能,因此叫SiP(System in Package)更准确。SiP封装足够小巧紧凑,但是其中功能模块十分固定,难以根据用户需要自由组合IP模块,也就是配置弹性偏低。
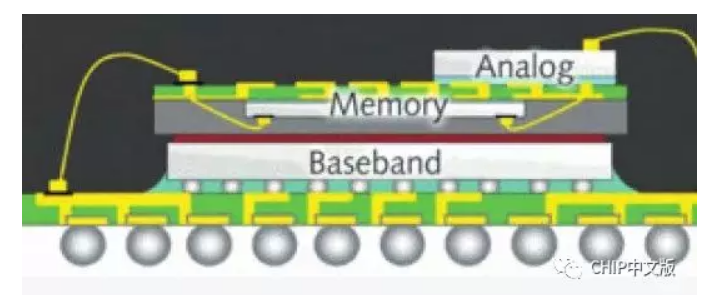
在去年年初,英特尔推出Kaby Lake-G令人眼前一亮,片上集成AMD Vega GPU和HBM2显存的Kaby Lake-G让EMIB(嵌入式多芯片互连桥接)封装技术进入人们眼帘,而该技术还只是2D封装,也就是所有芯片在一个平面上铺开。
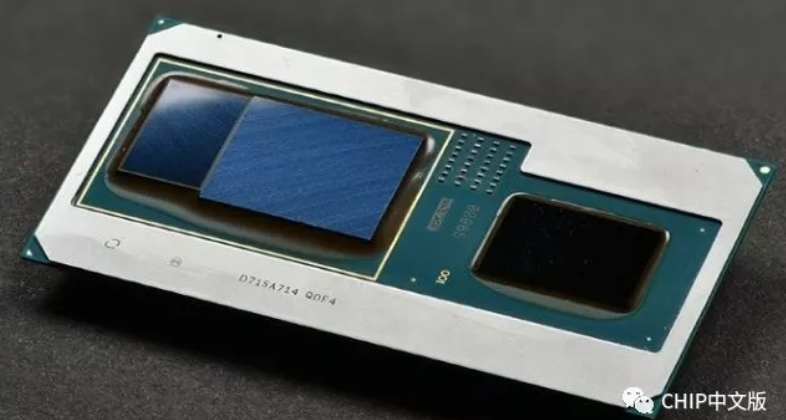
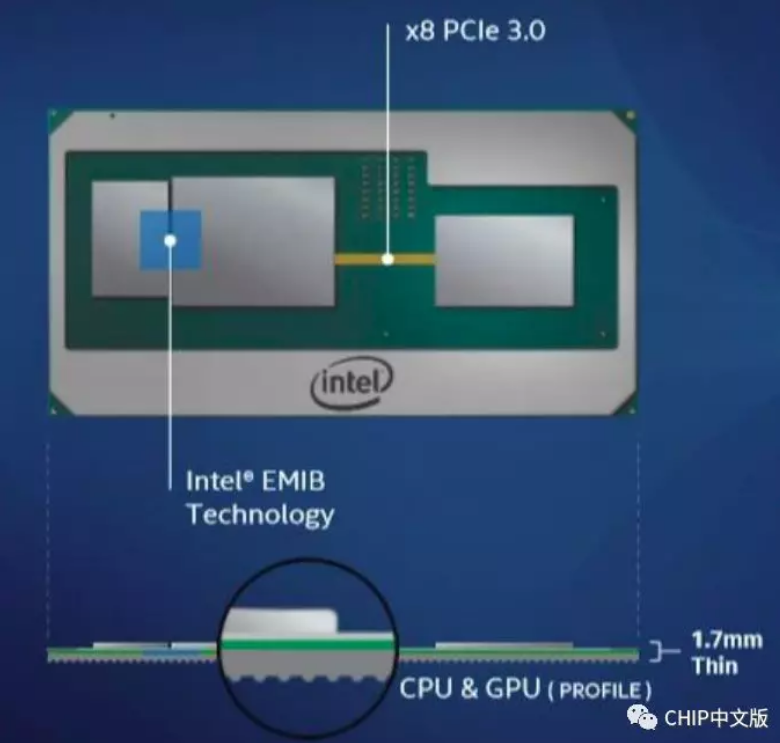
现在,英特尔已准备好将3D封装引入主流市场,也就是Foveros。Foveros 3D封装将多芯片封装从单独一个平面,变为立体式组合,从而大大提高集成密度,可以更灵活地组合不同芯片或者功能模块。

加入微信
获取电子行业最新资讯
搜索微信公众号:EEPW
或用微信扫描左侧二维码
相关文章
-
-
国际视野 2024-06-03
-
-
-
-
-
-