基于Si衬底的功率型GaN基LED制造技术
(1)采用多种在线控制技术,降低了外延材料中的刃位错和螺位错,改善了Si与GaN两者之间的热失配和晶格失配,解决了GaN单晶膜的龟裂问题,获得了厚度大于4 μm的无裂纹GaN外延膜。
(2)通过引入AIN,AlGaN多层缓冲层,大大缓解了Si衬底上外延GaN材料的应力,提高了晶体质量,从而提高了发光效率。
(3)通过优化设计n-GaN层中Si浓度结构及量子阱/垒之间的界面生长条件,减小了芯片的反向漏电流并提高了芯片的抗静电性能。
(4)通过调节p型层镁浓度结构,降低了器件的工作电压;通过优化p型GaN的厚度,改善了芯片的取光效率。
(5)通过优化外延层结构及掺杂分布,减小串联电阻,降低工作电压,减少热产生率,提升了LED的工作效率并改善器件的可靠性。
(6)采用多层金属结构,同时兼顾欧姆接触、反光特性、粘接特性和可靠性,优化焊接技术,解决了银反射镜与p-GaN粘附不牢且接触电阻大的问题。
(7)优选了多种焊接金属,优化焊接条件,成功获得了GaN薄膜和导电Si基板之间的牢固结合,解决了该过程中产生的裂纹问题。
(8)通过湿法和干法相结合的表面粗化,减少了内部全反射和波导效应引起的光损失,提高LED的外量子效率,使器件获得了较高的出光效率。
(9)解决了GaN表面粗化深度不够且粗化不均匀的问题,解决了粗化表面清洗不干净的难题并优化了N电极的金属结构,在粗化的N极性n-GaN表面获得了低阻且稳定的欧姆接触。
2 Si衬底LED封装技术
2.1 技术路线
采用蓝光LED激发YAG/硅酸盐/氮氧化物多基色体系荧光粉,发射黄、绿、红光,合成白光的技术路线。
工艺流程:在金属支架/陶瓷支架上装配蓝光LED芯片(导电胶粘结工艺)→键合(金丝球焊工艺)→荧光胶涂覆(自动化图形点胶/自动喷射工艺)→Si胶封装(模具灌胶工艺)→切筋→测试→包装。
2.2 主要封装工艺
Si衬底的功率型GaN基LED封装采用仿流明的支架封装形式,其外形有朗柏型、矩形和双翼型。其制作过程为:使用导热系数较高的194合金金属支架,先将LED芯片粘接在金属支架的反光杯底部,再通过键合工艺将金属引线连接LED芯片与金属支架电极,完成电气连接,最后用有机封装材料(如Si胶)覆盖芯片和电极引线,形成封装保护和光学通道。这种封装对于取光效率、散热性能、加大工作电流密度的设计都是最佳的。其主要特点包括:热阻低(小于10 ℃/W),可靠性高,封装内部填充稳定的柔性胶凝体,在-40~120℃范围,不会因温度骤变产生的内应力,使金丝与支架断开,并防止有机封装材料变黄,引线框架也不会因氧化而沾污;优化的封装结构设计使光学效率、外量子效率性能优异,其结构见图2。
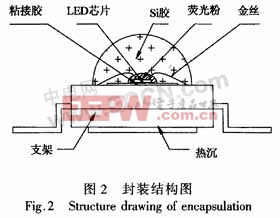
2.3 关键技术及创新性
功率型LED的热特性直接影响到LED的工作温度、发光效率、发光波长、使用寿命等,现有的Si衬底的功率型GaN基LED芯片设计采用了垂直结构来提高芯片的取光效率,改善了芯片的热特性,同时通过增大芯片面积,加大工作电流来提高器件的光电转换效率,从而获得较高的光通量,也因此给功率型LED的封装设计、制造技术带来新的课题。功率LED封装重点是采用有效的散热与不劣化的封装材料解决光衰问题。为达到封装技术要求,在大量的试验和探索中,分析解决相关技术问题,采用的关键技术和创新性有以下几点。
(1)通过设计新型陶瓷封装结构,减少了全反射,使器件获得高取光效率和合适的光学空间分布。
(2)采用电热隔离封装结构和优化的热沉设计,以适合薄膜芯片的封装要求。
(3)采用高导热系数的金属支架,选用导热导电胶粘结芯片,获得低热阻的良好散热通道,使产品光衰≤5%(1 000 h)。
(4)采用高效、高精度的荧光胶配比及喷涂工艺,保证了产品光色参数可控和一致性。
(5)多层复合封装,降低了封装应力,实施SSB键合工艺和多段固化制程,提高了产品的可靠性。

加入微信
获取电子行业最新资讯
搜索微信公众号:EEPW
或用微信扫描左侧二维码